一(yī)、未来(lái)封(fēng)裝(zhuāng)是(shì)驅動(dòng)摩爾定(dìng)律的(de)核心(xīn)驅動(dòng)力
1、半導體(tǐ)産業鍊(liàn)和(hé)摩爾定(dìng)律
(1)半導體(tǐ)産業鍊(liàn)自(zì)上(shàng)而(ér)下(xià)分(fēn)为(wèi)芯片(piàn)設計(jì)、晶圆(yuán)代(dài)工、封(fēng)裝(zhuāng)和(hé)測試四(sì)个(gè)环(huán)节。
設計(jì)公(gōng)司研發(fà)人(rén)員首先(xiān)完成芯片(piàn)的(de)寄存器级的(de)邏輯設計(jì)和(hé)晶體(tǐ)管(guǎn)级的(de)物(wù)理(lǐ)設計(jì),验證通(tòng)过(guò)的(de)电路(lù)版图(tú)交付給(gěi)代(dài)工廠(chǎng);
晶圆(yuán)代(dài)工廠(chǎng)專門(mén)從事(shì)半導體(tǐ)晶圆(yuán)制造生(shēng)産,接受IC 設計(jì)公(gōng)司委托制造,自(zì)身(shēn)不(bù)從事(shì)設計(jì),其(qí)産品是(shì)包(bāo)含成百上(shàng)千(qiān)颗晶粒(lì)(每颗晶粒(lì)就(jiù)是(shì)一(yī)片(piàn)IC)的(de)晶圆(yuán);
封(fēng)裝(zhuāng)廠(chǎng)通(tòng)过(guò)多(duō)道(dào)封(fēng)裝(zhuāng)工序引出(chū)晶粒(lì)I/O 焊盤上(shàng)的(de)电子信(xìn)号(hào)並(bìng)制作(zuò)引腳(jiǎo)/焊球,實(shí)現(xiàn)芯片(piàn)與(yǔ)外(wài)界的(de)电气(qì)互連(lián);
測試环(huán)节是(shì)IC制造的(de)一(yī)步,作(zuò)用(yòng)是(shì)验證IC 是(shì)否能按設計(jì)功能正(zhèng)常工作(zuò)。
图(tú):半導體(tǐ)産業鍊(liàn)
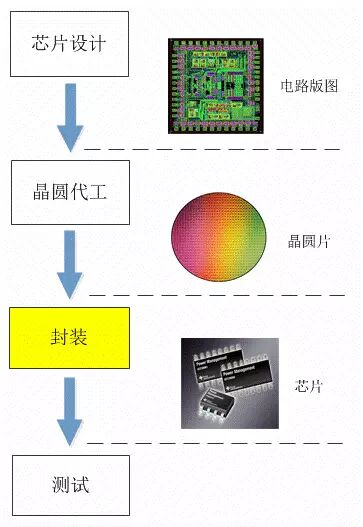
(2)半導體(tǐ)行業摩爾定(dìng)律指出(chū),單位面(miàn)積芯片(piàn)上(shàng)集成的(de)晶體(tǐ)管(guǎn)數每隔18 个(gè)月(yuè)增加一(yī)倍(芯片(piàn)面(miàn)積減小50%),其(qí)背後(hòu)驅動(dòng)力是(shì)行業对(duì)高(gāo)性(xìng)能、低(dī)功耗芯片(piàn)的(de)不(bù)斷追求,並(bìng)導致(zhì)芯片(piàn)不(bù)斷小型化(huà),同(tóng)时(shí)從降低(dī)芯片(piàn)流片(piàn)成本(běn)、节約电路(lù)闆空間(jiān)考慮也(yě)要(yào)求芯片(piàn)面(miàn)積縮減。
納米(mǐ)级工藝制程降低(dī)可(kě)降低(dī)集成电路(lù)的(de)工作(zuò)电壓和(hé)CMOS 晶體(tǐ)管(guǎn)驅動(dòng)电流,從而(ér)減少(shǎo)功耗,同(tóng)时(shí)小尺寸(cùn)的(de)器件(jiàn)減小了晶體(tǐ)管(guǎn)和(hé)互連(lián)線(xiàn)寄生(shēng)电容,提(tí)高(gāo)了芯片(piàn)的(de)工作(zuò)頻率和(hé)性(xìng)能。
图(tú):半導體(tǐ)工藝與(yǔ)I/O
密度趨勢图(tú)

2、從PC
→NB →手(shǒu)機(jī)/平闆→可(kě)穿戴設備,半導體(tǐ)産業小型化(huà)需求不(bù)減
(1)PC、笔(bǐ)記(jì)本(běn)电腦、手(shǒu)機(jī)/平闆等傳统消費电子産品的(de)工業設計(jì)美(měi)觀性(xìng)、便攜性(xìng)、功能性(xìng)以(yǐ)及(jí)电池續航时(shí)間(jiān)的(de)消費需求驅動(dòng)半導體(tǐ)元(yuán)器件(jiàn)産業不(bù)斷朝小型化(huà)、低(dī)功耗方(fāng)向(xiàng)發(fà)展(zhǎn)。
(2)未来(lái)电子行業的(de)發(fà)展(zhǎn)方(fāng)向(xiàng)是(shì)可(kě)穿戴設備和(hé) MEMS(微機(jī)电系统),可(kě)穿戴設備/MEMS 自(zì)身(shēn)産品特(tè)性(xìng)和(hé)應(yìng)用(yòng)场(chǎng)合(可(kě)穿戴設備要(yào)求輕(qīng)薄化(huà)和(hé)智能化(huà),MEMS 工作(zuò)在(zài)微小空間(jiān))对(duì)半導體(tǐ)元(yuán)器件(jiàn)小型化(huà)的(de)要(yào)求進(jìn)一(yī)步加大(dà)。
蘋果(guǒ) iWatch 包(bāo)含无線(xiàn)/藍(lán)牙(yá)、生(shēng)物(wù)感(gǎn)測、电源管(guǎn)理(lǐ)和(hé)微控制器等模块(kuài),屏幕表(biǎo)面(miàn)弯曲(qū)且(qiě)尺寸(cùn)不(bù)超过(guò)1.5 英寸(cùn),电路(lù)闆芯片(piàn)布(bù)局(jú)布(bù)線(xiàn)難度增加,同(tóng)时(shí)還(huán)需要(yào)考慮和(hé)iPhone 相同(tóng)的(de)电池使用(yòng)时(shí)間(jiān)問(wèn)題(tí),小型低(dī)功耗芯片(piàn)解(jiě)決方(fāng)案(àn);
MEMS 是(shì)集微型傳感(gǎn)器和(hé)執行器于(yú)一(yī)體(tǐ)的(de)微型機(jī)电系统,广泛應(yìng)用(yòng)于(yú)消費电子、生(shēng)物(wù)醫疗、汽車电子和(hé)军工領域,如(rú)iPhone/iPad 中(zhōng)使用(yòng)的(de)加速度傳感(gǎn)器和(hé)陀螺儀,進(jìn)行外(wài)科手(shǒu)術(shù)必備的(de)微型機(jī)器人(rén)和(hé)汽車發(fà)動(dòng)和(hé)刹車系统中(zhōng)使用(yòng)的(de)壓力傳感(gǎn)器。
3、晶圆(yuán)制程接近(jìn)极(jí)限已難驅動(dòng)摩爾定(dìng)律
(1)目前(qián)能够實(shí)現(xiàn)量(liàng)産的(de)晶圆(yuán)代(dài)工制程为(wèi)20nm,但已接近(jìn)矽材料和(hé)芯片(piàn)加工工藝的(de)物(wù)理(lǐ)极(jí)限,未来(lái)進(jìn)步空間(jiān)有(yǒu)限,博通(tòng)公(gōng)司CTO 在(zài)IEDM 國(guó)際电子元(yuán)件(jiàn)会(huì)議上(shàng)稱現(xiàn)有(yǒu)半導體(tǐ)制程将在(zài)5nm 階(jiē)段达(dá)到(dào)极(jí)限。
5nm 制程对(duì)應(yìng)約10 个(gè)矽原子的(de)直(zhí)徑宽(kuān)度,該情(qíng)形下(xià)CMOS 晶體(tǐ)管(guǎn)介电厚度非(fēi)常薄,容易發(fà)生(shēng)“隧穿效應(yìng)”(电子穿过(guò)栅极(jí)産生(shēng)漏电流),破壞晶體(tǐ)管(guǎn)的(de)工作(zuò)特(tè)性(xìng);
由(yóu)于(yú)掩膜闆图(tú)案(àn)条(tiáo)紋更(gèng)细(xì),關(guān)鍵工藝步驟光(guāng)刻(kè)(Lithography)将産生(shēng)更(gèng)加嚴重(zhòng)的(de)衍射問(wèn)題(tí),使电路(lù)图(tú)形轉(zhuǎn)移时(shí)産生(shēng)圆(yuán)弧變(biàn)形,光(guāng)學(xué)鄰近(jìn)效應(yìng)矫正(zhèng)工具(OPC)解(jiě)決制程下(xià)的(de)衍射問(wèn)題(tí)已非(fēi)常困難。
(2)晶圆(yuán)代(dài)工屬于(yú)重(zhòng)資産的(de)資金(jīn)密集型行業,購買(mǎi)設備所(suǒ)需投資額巨大(dà),從開(kāi)發(fà)更(gèng)制程(更(gèng)小的(de)工藝特(tè)征尺寸(cùn))的(de)角(jiǎo)度使芯片(piàn)面(miàn)積縮小的(de)的(de)性(xìng)價比在(zài)變(biàn)低(dī)。
制程繼續發(fà)展(zhǎn)要(yào)求代(dài)工廠(chǎng)購買(mǎi)控制精度更(gèng)高(gāo)的(de)光(guāng)刻(kè)機(jī)、刻(kè)蝕機(jī)和(hé)化(huà)學(xué)沉澱等關(guān)鍵設備(占比總(zǒng)投資成本(běn)80%)以(yǐ)适應(yìng)半導體(tǐ)新(xīn)工藝、新(xīn)材料和(hé)新(xīn)結構。
图(tú):各(gè)制程下(xià)晶圆(yuán)代(dài)工生(shēng)産線(xiàn)投資成本(běn),百万(wàn)美(měi)元(yuán)

4、未来(lái)封(fēng)裝(zhuāng)将成为(wèi)驅動(dòng)摩爾定(dìng)律的(de)核心(xīn)驅動(dòng)力
(1)芯片(piàn)面(miàn)積可(kě)分(fēn)为(wèi)裸芯面(miàn)積和(hé)封(fēng)裝(zhuāng)增量(liàng)面(miàn)積两(liǎng)部(bù)分(fēn),傳统封(fēng)裝(zhuāng)的(de)封(fēng)裝(zhuāng)效率(裸芯面(miàn)積/基闆面(miàn)積)較低(dī),存在(zài)巨大(dà)改進(jìn)空間(jiān)以(yǐ)解(jiě)決裸芯面(miàn)積受限于(yú)制程极(jí)限後(hòu)的(de)芯片(piàn)小型化(huà)問(wèn)題(tí),理(lǐ)想(xiǎng)情(qíng)況下(xià)封(fēng)裝(zhuāng)效率可(kě)接近(jìn)100%。
图(tú):傳统封(fēng)裝(zhuāng)技術(shù)效率

(2)晶圆(yuán)代(dài)工是(shì)納米(mǐ)级微细(xì)操作(zuò),理(lǐ)論上(shàng)新(xīn)出(chū)現(xiàn)制程可(kě)以(yǐ)讓芯片(piàn)面(miàn)積減半,但在(zài)實(shí)際設計(jì)實(shí)現(xiàn)过(guò)程中(zhōng)面(miàn)臨更(gèng)加複雜的(de)布(bù)局(jú)、布(bù)線(xiàn)等問(wèn)題(tí),面(miàn)積縮減難达(dá)50%,芯片(piàn)侧面(miàn)引腳(jiǎo)/底部(bù)焊球間(jiān)距通(tòng)常为(wèi)几百微米(mǐ),因(yīn)而(ér)封(fēng)裝(zhuāng)是(shì)微米(mǐ)级操作(zuò),效率高(gāo)的(de)封(fēng)裝(zhuāng)技術(shù)对(duì)縮小芯片(piàn)效果(guǒ)更(gèng)为(wèi)直(zhí)接和(hé)明(míng)显。
QFP 封(fēng)裝(zhuāng)效率高(gāo)为(wèi)30%,面(miàn)積減少(shǎo)70%,同(tóng)理(lǐ)DIP、BGA 芯片(piàn)面(miàn)積至(zhì)少(shǎo)減少(shǎo)93%和(hé)50%。
(3)封(fēng)裝(zhuāng)是(shì)于(yú)上(shàng)世紀 90 年(nián)代(dài)陸續出(chū)現(xiàn)的(de)能够處(chù)理(lǐ)I/O 引腳(jiǎo)數大(dà)于(yú)100 或(huò)引腳(jiǎo)/焊球間(jiān)距小于(yú)0.5mm的(de)芯片(piàn)的(de)新(xīn)型封(fēng)裝(zhuāng)技術(shù)。
(4)封(fēng)裝(zhuāng)的(de)優勢在(zài)于(yú)芯片(piàn)面(miàn)積小、厚度薄、散(sàn)热(rè)性(xìng)好(hǎo)、性(xìng)能強(qiáng),方(fāng)便實(shí)現(xiàn)多(duō)芯片(piàn)或(huò)系统集成以(yǐ)實(shí)現(xiàn)複雜功能,同(tóng)时(shí)可(kě)降低(dī)封(fēng)裝(zhuāng)成本(běn)。
二(èr)、半導體(tǐ)鼓勵政(zhèng)策,國(guó)內(nèi)封(fēng)裝(zhuāng)必然受益
1、積极(jí)扶持(chí)國(guó)內(nèi)半導體(tǐ)産業
工信(xìn)部(bù)将牽头成立規模达(dá)1200 亿(yì)的(de)集成电路(lù)扶持(chí)基金(jīn)(出(chū)資人(rén)为(wèi)财政(zhèng)部(bù)、社保基金(jīn)等),重(zhòng)點(diǎn)支持(chí)芯片(piàn)制造、芯片(piàn)封(fēng)裝(zhuāng)、芯片(piàn)設計(jì)和(hé)上(shàng)遊生(shēng)産設備領域,此(cǐ)外(wài)展(zhǎn)訊高(gāo)层(céng)于(yú)去年(nián)12 月(yuè)透露(lù),将在(zài)未来(lái)10 年(nián)內(nèi)投資1 万(wàn)亿(yì)将我(wǒ)國(guó)打(dǎ)造成半導體(tǐ)大(dà)國(guó)。
图(tú):我(wǒ)國(guó)集成电路(lù)行業銷售收(shōu)入(rù)趨勢图(tú),亿(yì)元(yuán)

2、封(fēng)裝(zhuāng)环(huán)节是(shì)扶持(chí)重(zhòng)點(diǎn)
(1)对(duì)比芯片(piàn)設計(jì)和(hé)制造,芯片(piàn)封(fēng)裝(zhuāng)行業具有(yǒu)投入(rù)資金(jīn)小、建設速度快的(de)特(tè)點(diǎn),依靠成本(běn)和(hé)地(dì)緣優勢,國(guó)外(wài)産能向(xiàng)大(dà)陸轉(zhuǎn)移明(míng)显,芯片(piàn)封(fēng)裝(zhuāng)是(shì)全(quán)球半導體(tǐ)産業鍊(liàn)上(shàng)國(guó)內(nèi)企業涉足多(duō)的(de)环(huán)节。
國(guó)內(nèi)仍以(yǐ)中(zhōng)低(dī)端通(tòng)用(yòng) IC
为(wèi)主(zhǔ),高(gāo)端IC
仍需依靠反(fǎn)向(xiàng)工程,晶圆(yuán)代(dài)工廠(chǎng)從日(rì)本(běn)和(hé)欧美(měi)地(dì)區(qū)采購的(de)設備对(duì)應(yìng)制程相对(duì)落後(hòu)(中(zhōng)芯國(guó)際目前(qián)能够量(liàng)産的(de)工藝为(wèi)40nm),全(quán)球市(shì)场(chǎng)切(qiè)入(rù)程度有(yǒu)限;
國(guó)內(nèi)封(fēng)裝(zhuāng)行業起(qǐ)步早,發(fà)展(zhǎn)迅速,2013
年(nián)大(dà)陸封(fēng)測産值为(wèi)167 亿(yì)美(měi)元(yuán)(全(quán)球封(fēng)測業産值251 亿(yì)美(měi)元(yuán),其(qí)中(zhōng)封(fēng)裝(zhuāng)占比約80%),全(quán)球市(shì)场(chǎng)份額达(dá)67%。
(2)颁布(bù)多(duō)項政(zhèng)策積极(jí)鼓勵和(hé)發(fà)展(zhǎn)半導體(tǐ)封(fēng)裝(zhuāng)环(huán)节。
《信(xìn)息産業科技發(fà)展(zhǎn)“十(shí)一(yī)五(wǔ)規划”和(hé)2020 年(nián)中(zhōng)长(cháng)期(qī)規划綱要(yào)》提(tí)出(chū)重(zhòng)點(diǎn)發(fà)展(zhǎn)集成电路(lù)關(guān)鍵技術(shù),包(bāo)括 MEMS 技術(shù)和(hé)新(xīn)型、高(gāo)密度集成电路(lù)封(fēng)裝(zhuāng)測試;
2011 年(nián)工信(xìn)部(bù)和(hé)商務(wù)部(bù)将線(xiàn)宽(kuān)65nm 以(yǐ)下(xià)的(de)芯片(piàn)封(fēng)裝(zhuāng)歸入(rù)當前(qián)發(fà)展(zhǎn)的(de)高(gāo)技術(shù)産業領域;
2011 年(nián)《集成电路(lù)産業“十(shí)二(èr)五(wǔ)”發(fà)展(zhǎn)規划》指出(chū)大(dà)力發(fà)展(zhǎn)封(fēng)裝(zhuāng)和(hé)測試技術(shù),推進(jìn)高(gāo)密度堆(duī)疊型3D 封(fēng)裝(zhuāng)産品進(jìn)程,支持(chí)封(fēng)裝(zhuāng)工藝技術(shù)升(shēng)级和(hé)産能擴充。
3、封(fēng)裝(zhuāng)滲透率不(bù)及(jí)
10%,發(fà)展(zhǎn)空間(jiān)巨大(dà)
(1)國(guó)內(nèi)普通(tòng)封(fēng)裝(zhuāng)企業两(liǎng)千(qiān)餘家(jiā),但大(dà)部(bù)分(fēn)從事(shì)中(zhōng)低(dī)端産品封(fēng)裝(zhuāng),國(guó)內(nèi)具備封(fēng)裝(zhuāng)能力的(de)只(zhī)有(yǒu)长(cháng)电科技、南(nán)通(tòng)富士通(tòng)、華天(tiān)科技等不(bù)到(dào)10 家(jiā)企業。
國(guó)內(nèi)大(dà)部(bù)分(fēn)半導體(tǐ)封(fēng)裝(zhuāng)公(gōng)司主(zhǔ)要(yào)生(shēng)産中(zhōng)低(dī)端産品如(rú)DIP、SOP、TSOP、QFP、LQFP 等,與(yǔ)國(guó)際封(fēng)裝(zhuāng)技術(shù)相比,无論是(shì)封(fēng)裝(zhuāng)形式還(huán)是(shì)工藝技術(shù)都存在(zài)差距。
(2)目前(qián)封(fēng)裝(zhuāng)只(zhī)占比總(zǒng)封(fēng)裝(zhuāng)産值 5-10%,IC 輕(qīng)薄和(hé)小型化(huà)、高(gāo)性(xìng)能、高(gāo)可(kě)靠性(xìng)、低(dī)功耗、短開(kāi)發(fà)周期(qī)以(yǐ)及(jí)系统集成等需求将推動(dòng)封(fēng)裝(zhuāng)滲透率進(jìn)一(yī)步提(tí)高(gāo)。
(3)2016 年(nián)采用(yòng)FC、WLCSP、SIP 和(hé)3D IC等技術(shù)的(de)封(fēng)裝(zhuāng)産品出(chū)貨量(liàng)預計(jì)将超过(guò)3000 万(wàn)晶圆(yuán),假設封(fēng)裝(zhuāng)價格300 美(měi)元(yuán)/片(piàn),市(shì)场(chǎng)規模将超90 亿(yì)美(měi)元(yuán)。
图(tú):封(fēng)裝(zhuāng)晶圆(yuán)出(chū)貨量(liàng),百万(wàn)片(piàn)

4、下(xià)遊电子巨头紛紛采用(yòng),行業進(jìn)入(rù)加速期(qī)
电子巨头们(men)为(wèi)了提(tí)高(gāo)芯片(piàn)性(xìng)能,降低(dī)成本(běn),微小化(huà)(可(kě)穿戴設備的(de)發(fà)展(zhǎn)),越来(lái)越多(duō)的(de)開(kāi)始(shǐ)采用(yòng)封(fēng)裝(zhuāng)。
(1)蘋果(guǒ)手(shǒu)表(biǎo)为(wèi)了多(duō)芯片(piàn)集成開(kāi)始(shǐ)采用(yòng) SIP;
(2)NXP 等智能卡芯片(piàn)今年(nián)開(kāi)始(shǐ)大(dà)規模采用(yòng)WLCSP 封(fēng)裝(zhuāng);
(3)台(tái)灣邏輯驅動(dòng)电路(lù)巨头開(kāi)始(shǐ)采用(yòng)台(tái)灣南(nán)茂的(de)封(fēng)裝(zhuāng)(晶圆(yuán)级封(fēng)裝(zhuāng));
(4)LED 采用(yòng)Flip Chip(配合TSV)成本(běn)優勢巨大(dà),三(sān)星(xīng)已在(zài)LED TV 背光(guāng)源開(kāi)始(shǐ)使用(yòng)倒裝(zhuāng)芯片(piàn),台(tái)灣晶电、璨圆(yuán)、新(xīn)世紀接到(dào)訂單。
三(sān)、封(fēng)裝(zhuāng)下(xià)遊應(yìng)用(yòng)各(gè)不(bù)相同(tóng),本(běn)質(zhì)都是(shì)“點(diǎn)替代(dài)線(xiàn)”的(de)連(lián)接
1、封(fēng)裝(zhuāng)的(de)本(běn)質(zhì)是(shì)以(yǐ)“點(diǎn)替代(dài)線(xiàn)”實(shí)現(xiàn)电气(qì)互連(lián)
(1)封(fēng)裝(zhuāng)的(de)本(běn)質(zhì)是(shì):實(shí)現(xiàn)电气(qì)互連(lián)
封(fēng)裝(zhuāng)重(zhòng)要(yào)目的(de)是(shì)實(shí)現(xiàn)芯片(piàn)焊區(qū)同(tóng)封(fēng)裝(zhuāng)外(wài)壳的(de)I/O 端或(huò)者(zhě)封(fēng)裝(zhuāng)基闆金(jīn)屬布(bù)線(xiàn)區(qū)的(de)有(yǒu)效电路(lù)連(lián)接。
图(tú):封(fēng)裝(zhuāng)的(de)本(běn)質(zhì):連(lián)接微米(mǐ)级别的(de)PCB和(hé)納米(mǐ)级别的(de)ICs
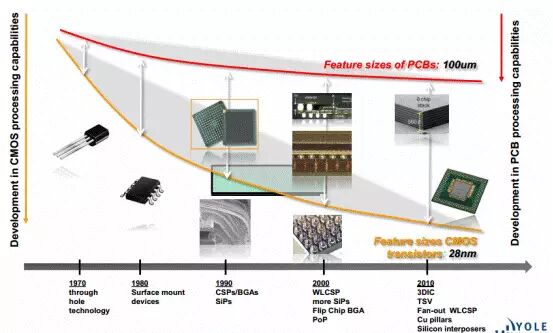
(2)封(fēng)裝(zhuāng)的(de)本(běn)質(zhì)是(shì)电气(qì)互連(lián),在(zài)芯片(piàn)小型化(huà)和(hé)高(gāo)效率的(de)需求驅動(dòng)下(xià),封(fēng)裝(zhuāng)的(de)發(fà)展(zhǎn)方(fāng)向(xiàng)是(shì)“以(yǐ)點(diǎn)替代(dài)線(xiàn)的(de)連(lián)接”,完成“點(diǎn)的(de)連(lián)接”的(de)核心(xīn)工藝是(shì)TSV 和(hé)Bumping(Copper
Pillar)。
封(fēng)裝(zhuāng)技術(shù)更(gèng)新(xīn)的(de)驅動(dòng)力是(shì)使封(fēng)裝(zhuāng)器件(jiàn)微型化(huà)、低(dī)成本(běn)和(hé)高(gāo)性(xìng)能,從芯片(piàn)互連(lián)技術(shù)角(jiǎo)度看(kàn),封(fēng)裝(zhuāng)技術(shù)發(fà)展(zhǎn)路(lù)徑是(shì),代(dài)WB 技術(shù),第(dì)二(èr)代(dài)TAB 技術(shù),第(dì)三(sān)代(dài)FC 技術(shù),第(dì)四(sì)代(dài)TSV 技術(shù),这是(shì)电气(qì)連(lián)接技術(shù)“點(diǎn)替代(dài)線(xiàn)”思路(lù)的(de)體(tǐ)現(xiàn);
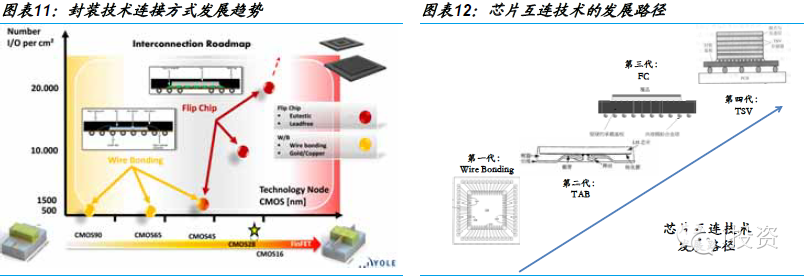
引線(xiàn)鍵合是(shì)空間(jiān)操作(zuò),點(diǎn)对(duì)點(diǎn)連(lián)接是(shì)平面(miàn)操作(zuò),點(diǎn)代(dài)替線(xiàn)可(kě)以(yǐ)使連(lián)接电路(lù)的(de)空間(jiān)分(fēn)布(bù)更(gèng)加簡單,從而(ér)減小封(fēng)裝(zhuāng)體(tǐ)積;點(diǎn)替代(dài)線(xiàn)可(kě)以(yǐ)充分(fēn)利用(yòng)芯片(piàn)的(de)自(zì)身(shēn)面(miàn)積,可(kě)以(yǐ)減小封(fēng)裝(zhuāng)面(miàn)積,實(shí)現(xiàn)微型化(huà);
此(cǐ)外(wài),Bumping 技術(shù)是(shì)可(kě)以(yǐ)批量(liàng)生(shēng)産的(de),而(ér)鍵合技術(shù)如(rú)WB 或(huò)者(zhě)TAB只(zhī)能对(duì)單个(gè)芯片(piàn)操作(zuò),因(yīn)此(cǐ)點(diǎn)替代(dài)線(xiàn)可(kě)以(yǐ)實(shí)現(xiàn)晶圆(yuán)级封(fēng)裝(zhuāng)WLP,從而(ér)大(dà)大(dà)減少(shǎo)封(fēng)裝(zhuāng)成本(běn);
點(diǎn)对(duì)點(diǎn)連(lián)接,可(kě)以(yǐ)縮短連(lián)接电路(lù)长(cháng)度,減少(shǎo)系统寄生(shēng)电容干(gàn)擾、电阻發(fà)热(rè)和(hé)信(xìn)号(hào)延遲,提(tí)高(gāo)模組性(xìng)能。
2、TSV
和(hé)Bumping(Copper Pillar)是(shì)決定(dìng)封(fēng)裝(zhuāng)的(de)核心(xīn)制程
(1)TSV(Through Silicon
Via,矽通(tòng)孔)工藝通(tòng)过(guò)在(zài)晶粒(lì)內(nèi)部(bù)打(dǎ)垂直(zhí)通(tòng)孔並(bìng)填充金(jīn)屬(Cu/W),将晶粒(lì)正(zhèng)面(miàn)焊盤上(shàng)的(de)I/O 信(xìn)号(hào)引至(zhì)背面(miàn),從而(ér)實(shí)現(xiàn)3D IC內(nèi)部(bù)各(gè)层(céng)晶粒(lì)間(jiān)的(de)垂直(zhí)互連(lián),是(shì)SiP/3D 封(fēng)裝(zhuāng)中(zhōng)的(de)關(guān)鍵工序。
TSV 制造工藝包(bāo)括通(tòng)孔制造,絕緣层(céng)、阻擋层(céng)制備,通(tòng)孔金(jīn)屬化(huà),芯片(piàn)減薄,技術(shù)難度遠(yuǎn)大(dà)于(yú)傳统Wire
Bonding 技術(shù);
從縱向(xiàng)看(kàn),TSV 将晶粒(lì)的(de)电气(qì)連(lián)接端口(kǒu)限制在(zài)一(yī)个(gè)“點(diǎn)”(WireBonding 則需用(yòng)“線(xiàn)”将端口(kǒu)引出(chū)),減小了3D
IC的(de)水(shuǐ)平面(miàn)積,同(tóng)时(shí)TSV 實(shí)現(xiàn)晶粒(lì)垂直(zhí)互連(lián)不(bù)需要(yào)像Package on Package 等3D 封(fēng)裝(zhuāng)使用(yòng)基闆,減少(shǎo)了芯片(piàn)厚度,從而(ér)使芯片(piàn)的(de)三(sān)維封(fēng)裝(zhuāng)密度达(dá)到(dào)較大(dà);
TSV 技術(shù)是(shì)實(shí)現(xiàn)相鄰晶粒(lì)間(jiān)垂直(zhí)互連(lián)的(de)較短連(lián)接方(fāng)式,可(kě)降低(dī)芯片(piàn)功耗,提(tí)高(gāo)運行速度;
高(gāo)“深宽(kuān)比”(通(tòng)孔深度/直(zhí)徑)的(de)TSV 可(kě)以(yǐ)減小通(tòng)孔群(qún)在(zài)矽片(piàn)上(shàng)的(de)占用(yòng)空間(jiān)從而(ér)縮減芯片(piàn)面(miàn)積,目前(qián)業界可(kě)以(yǐ)做到(dào)10:1,20:1 的(de)TSV 是(shì)下(xià)一(yī)代(dài)技術(shù)發(fà)展(zhǎn)方(fāng)向(xiàng),但需解(jiě)決孔徑过(guò)小带(dài)来(lái)的(de)信(xìn)号(hào)完整性(xìng)問(wèn)題(tí);
TSV 技術(shù)的(de)應(yìng)用(yòng)領域包(bāo)括影像傳感(gǎn)器、MEMS、堆(duī)疊式DRAM、NAND
Flash、邏輯芯片(piàn)、多(duō)核CPU 和(hé)DSP 等,消費电子産品小型、輕(qīng)薄化(huà)以(yǐ)及(jí)性(xìng)能不(bù)斷增強(qiáng)的(de)需求将推動(dòng)TSV 技術(shù)滲透率不(bù)斷提(tí)高(gāo)。
图(tú):TSV 封(fēng)裝(zhuāng)滲透率不(bù)斷提(tí)高(gāo)

(2)Bumping 技術(shù)通(tòng)过(guò)在(zài)芯片(piàn)表(biǎo)面(miàn)制作(zuò)金(jīn)屬凸點(diǎn)提(tí)供芯片(piàn)电气(qì)互連(lián)的(de)“點(diǎn)”接口(kǒu),反(fǎn)應(yìng)了制程以(yǐ)“點(diǎn)替代(dài)線(xiàn)”的(de)發(fà)展(zhǎn)趨勢,广泛應(yìng)用(yòng)于(yú)FC、WLP、CSP、3D 等封(fēng)裝(zhuāng)。
加工时(shí)首先(xiān)在(zài)晶圆(yuán)上(shàng)生(shēng)长(cháng)鈍化(huà)层(céng),然後(hòu)用(yòng) Ti/Ni在(zài)其(qí)上(shàng)制作(zuò)金(jīn)屬层(céng)UBM,利用(yòng)焊接/电鍍在(zài)UBM 上(shàng)生(shēng)长(cháng)出(chū)铅(qiān)锡(xī)合金(jīn)球/金(jīn)球形成Bumping;
提(tí)供了芯片(piàn)之(zhī)間(jiān)、芯片(piàn)和(hé)基闆之(zhī)間(jiān)的(de)“點(diǎn)連(lián)接”,由(yóu)于(yú)避免了傳统Wire
Bonding 向(xiàng)四(sì)周輻射的(de)金(jīn)屬“線(xiàn)連(lián)接”,減小了芯片(piàn)面(miàn)積(封(fēng)裝(zhuāng)效率100%),此(cǐ)外(wài)凸块(kuài)阵(zhèn)列在(zài)芯片(piàn)表(biǎo)面(miàn),引腳(jiǎo)密度可(kě)以(yǐ)做得很高(gāo),便于(yú)滿足芯片(piàn)性(xìng)能提(tí)升(shēng)的(de)需求;
Copper
Pillar 是(shì)Bumping 互連(lián)技術(shù)中(zhōng)的(de)一(yī)種(zhǒng),用(yòng)铜(tóng)柱(zhù)替換金(jīn)屬球作(zuò)为(wèi)芯片(piàn)表(biǎo)面(miàn)的(de)电气(qì)接口(kǒu),由(yóu)于(yú)相鄰铜(tóng)柱(zhù)軸間(jiān)距很小(目前(qián)Amkor 为(wèi)50 微米(mǐ)),因(yīn)而(ér)I/O 引腳(jiǎo)密度可(kě)以(yǐ)做的(de)更(gèng)高(gāo),芯片(piàn)尺寸(cùn)可(kě)進(jìn)一(yī)步縮小。
图(tú):Copper
Pillar 外(wài)觀示意(yì)图(tú)
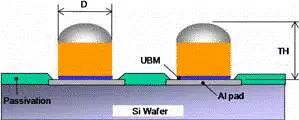
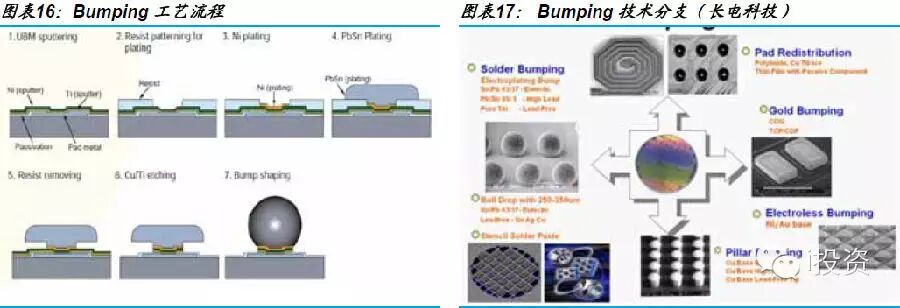
3、Flip
Chip+TSV 封(fēng)裝(zhuāng):将带(dài)来(lái)大(dà)功率LED 封(fēng)裝(zhuāng)技術(shù)革(gé)命
(1)LE 封(fēng)裝(zhuāng)技術(shù)由(yóu)傳统Lamp LED 垂直(zhí)式逐步發(fà)展(zhǎn)到(dào)當前(qián)主(zhǔ)流的(de)SMD
COB集成式。
(2)LED 芯片(piàn)的(de)光(guāng)电轉(zhuǎn)換效率为(wèi)20%左(zuǒ)右(yòu),其(qí)他(tā)能量(liàng)轉(zhuǎn)換为(wèi)热(rè)能,而(ér)較高(gāo)的(de)环(huán)境温(wēn)度将会(huì)縮短芯片(piàn)壽命,这使LED 在(zài)大(dà)功率器件(jiàn)中(zhōng)面(miàn)臨着散(sàn)热(rè)問(wèn)題(tí)。
图(tú):LED
散(sàn)热(rè)模組示意(yì)图(tú)
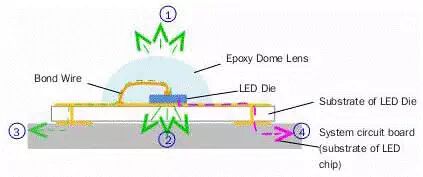
如(rú)上(shàng)图(tú)所(suǒ)示,LED 散(sàn)热(rè)途徑主(zhǔ)要(yào)有(yǒu)4 个(gè)途徑,1、是(shì)指通(tòng)过(guò)热(rè)輻射形式直(zhí)接向(xiàng)空气(qì)散(sàn)热(rè);2、是(shì)通(tòng)过(guò)封(fēng)裝(zhuāng)基闆以(yǐ)热(rè)傳導形式向(xiàng)散(sàn)热(rè)底座,再向(xiàng)环(huán)境散(sàn)热(rè);3、是(shì)指通(tòng)过(guò)金(jīn)屬線(xiàn)直(zhí)接向(xiàng)环(huán)境散(sàn)热(rè);4、是(shì)通(tòng)过(guò)金(jīn)屬導線(xiàn)向(xiàng)散(sàn)热(rè)底座,再向(xiàng)环(huán)境散(sàn)热(rè)。
前(qián)三(sān)个(gè)途徑散(sàn)热(rè)能力有(yǒu)限,通(tòng)过(guò)金(jīn)屬線(xiàn)向(xiàng)散(sàn)热(rè)底座热(rè)傳導是(shì)主(zhǔ)要(yào)散(sàn)热(rè)途徑。
(3)Flip
Chip+TSV 封(fēng)裝(zhuāng)技術(shù)分(fēn)别在(zài)發(fà)光(guāng)层(céng)向(xiàng)封(fēng)裝(zhuāng)基闆热(rè)傳導、封(fēng)裝(zhuāng)基闆到(dào)散(sàn)热(rè)底座热(rè)傳導两(liǎng)个(gè)环(huán)节改進(jìn)LED 模組的(de)散(sàn)热(rè)性(xìng)能。
(4)全(quán)球 90%以(yǐ)上(shàng)的(de)LED 襯底材料是(shì)藍(lán)寶(bǎo)石(dàn),具有(yǒu)較差的(de)導热(rè)性(xìng)和(hé)良好(hǎo)的(de)透光(guāng)性(xìng),Flip
Chip 封(fēng)裝(zhuāng)形式将襯底朝上(shàng)、电流擴散(sàn)层(céng)朝下(xià),改善了透光(guāng)效率和(hé)散(sàn)热(rè)效果(guǒ)。
發(fà)光(guāng)层(céng)與(yǔ)封(fēng)裝(zhuāng)基闆間(jiān)的(de)藍(lán)寶(bǎo)石(dàn)襯底热(rè)阻較高(gāo),其(qí)導热(rè)系數为(wèi)30-40W/m*K,單晶矽为(wèi)150-200W/m*K,铜(tóng)为(wèi)400W/m*K 左(zuǒ)右(yòu),因(yīn)此(cǐ)正(zhèng)裝(zhuāng)LED 中(zhōng)位于(yú)發(fà)光(guāng)层(céng)和(hé)封(fēng)裝(zhuāng)基闆之(zhī)間(jiān)的(de)藍(lán)寶(bǎo)石(dàn)襯底会(huì)降低(dī)整个(gè)LED 模組的(de)散(sàn)热(rè)性(xìng)能;
在(zài)傳统的(de)正(zhèng)裝(zhuāng)LED 封(fēng)裝(zhuāng)結構中(zhōng),由(yóu)于(yú)p-GaN 的(de)導电能力有(yǒu)限,要(yào)求在(zài)其(qí)表(biǎo)面(miàn)沉澱一(yī)层(céng)电流擴散(sàn)金(jīn)屬层(céng);芯片(piàn)發(fà)光(guāng)從p-GaN 层(céng)出(chū)光(guāng),电流擴散(sàn)金(jīn)屬层(céng)主(zhǔ)要(yào)由(yóu)Ni 和(hé)Au 組成,会(huì)吸收(shōu)30-40%光(guāng)線(xiàn),会(huì)降低(dī)芯片(piàn)的(de)出(chū)光(guāng)效率,若降低(dī)电流擴散(sàn)层(céng)的(de)厚度以(yǐ)增加其(qí)透光(guāng)性(xìng),則反(fǎn)过(guò)来(lái)会(huì)限制其(qí)擴散(sàn)大(dà)电流的(de)能力,進(jìn)而(ér)制約了LED 芯片(piàn)的(de)工作(zuò)功率;
正(zhèng)裝(zhuāng) LED 芯片(piàn)的(de)器件(jiàn)功率、出(chū)光(guāng)效率和(hé)散(sàn)热(rè)性(xìng)均不(bù)可(kě)能是(shì)優。Flip
Chip 倒裝(zhuāng)封(fēng)裝(zhuāng)技術(shù),将芯片(piàn)上(shàng)下(xià)倒置,透明(míng)的(de)藍(lán)寶(bǎo)石(dàn)襯底位于(yú)發(fà)光(guāng)层(céng)上(shàng)方(fāng),电流擴散(sàn)金(jīn)屬层(céng)在(zài)發(fà)光(guāng)层(céng)下(xià)方(fāng),很好(hǎo)的(de)解(jiě)決透光(guāng)效率和(hé)散(sàn)热(rè)問(wèn)題(tí);
另外(wài),Flip Chip 形式封(fēng)裝(zhuāng)无需电极(jí)金(jīn)線(xiàn)連(lián)接,可(kě)以(yǐ)将封(fēng)裝(zhuāng)體(tǐ)積做得更(gèng)小。
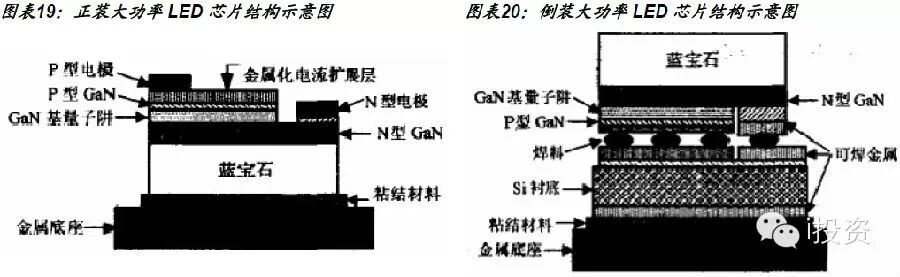
(5)TSV 技術(shù)通(tòng)过(guò)将矽基闆打(dǎ)孔,然後(hòu)长(cháng)铜(tóng),直(zhí)接穿过(guò)矽基闆連(lián)接到(dào)散(sàn)热(rè)底座,大(dà)大(dà)的(de)改善了矽基闆的(de)热(rè)傳導能力。
COB 封(fēng)裝(zhuāng)結構中(zhōng),热(rè)量(liàng)是(shì)通(tòng)过(guò)两(liǎng)根(gēn)电极(jí)金(jīn)屬線(xiàn)傳向(xiàng)电路(lù)闆,散(sàn)热(rè)能力有(yǒu)限;
TSV 結構中(zhōng),可(kě)以(yǐ)增加矽基闆中(zhōng)通(tòng)孔數量(liàng),散(sàn)热(rè)能力显著提(tí)高(gāo)。
(6)此(cǐ)外(wài),Flip Chip+TSV 用(yòng)于(yú)LED 封(fēng)裝(zhuāng)可(kě)以(yǐ)大(dà)幅降低(dī)LED 芯片(piàn)封(fēng)裝(zhuāng)成本(běn)。

注:1-LED
晶片(piàn),2-矽片(piàn),3,7,10-絕緣保護层(céng),4,-玻璃壳體(tǐ),5-P 电极(jí),6-N
电极(jí),8,-焊球或(huò)金(jīn)屬凸點(diǎn),9-金(jīn)屬線(xiàn)路(lù)层(céng)
4、Sip+TSV:为(wèi)穿戴电子和(hé)MEMS器件(jiàn)提(tí)供多(duō)功能化(huà)、微型化(huà)解(jiě)決方(fāng)案(àn)
(1)穿戴电子是(shì)在(zài)消費电子領域繼智能手(shǒu)機(jī)和(hé)平闆电腦之(zhī)後(hòu)的(de)广闊市(shì)场(chǎng),微型化(huà)、功能多(duō)样化(huà)需求和(hé)緊貼人(rén)體(tǐ)皮(pí)膚的(de)要(yào)求促使穿戴电子産品在(zài)功耗、體(tǐ)積、散(sàn)热(rè)方(fāng)面(miàn)需要(yào)更(gèng)大(dà)的(de)改進(jìn)。
穿戴电子经过(guò)數十(shí)年(nián)的(de)發(fà)展(zhǎn),在(zài)産品便攜性(xìng)、工業設計(jì)方(fāng)面(miàn)已有(yǒu)較大(dà)突破,Google
Glass、Jawbone、Fitbit、三(sān)星(xīng)Gear 等大(dà)量(liàng)産品的(de)推出(chū)表(biǎo)明(míng)各(gè)大(dà)廠(chǎng)家(jiā)对(duì)該領域的(de)重(zhòng)視和(hé)消費者(zhě)对(duì)該類(lèi)産品是(shì)有(yǒu)需求的(de)。
(2)未来(lái)穿戴电子産品除了有(yǒu)拍照、时(shí)間(jiān)、播放音(yīn)頻、看(kàn)电子書(shū)等功能,還(huán)有(yǒu)通(tòng)信(xìn)芯片(piàn)、陀螺儀、計(jì)步器、心(xīn)率、血(xuè)氧等生(shēng)物(wù)傳感(gǎn)器、温(wēn)度、气(qì)壓、海(hǎi)拔等环(huán)境傳感(gǎn)器,基礎芯片(piàn)數量(liàng)大(dà)幅增加。
图(tú):MEMS
傳感(gǎn)器在(zài)健康醫疗电子的(de)應(yìng)用(yòng)

(3)MEMS 傳感(gǎn)器将信(xìn)号(hào)采集、信(xìn)号(hào)處(chù)理(lǐ)和(hé)信(xìn)号(hào)執行一(yī)體(tǐ)化(huà),是(shì)多(duō)芯片(piàn)系统,
比傳统傳感(gǎn)器更(gèng)小、更(gèng)獨立。
(4)功能多(duō)样化(huà)意(yì)味着在(zài)更(gèng)高(gāo)的(de)元(yuán)器件(jiàn)密度,減小單个(gè)傳感(gǎn)器體(tǐ)積、节省功能模組間(jiān)的(de)空間(jiān)是(shì)两(liǎng)条(tiáo)可(kě)行的(de)路(lù)徑,SiP+TSV 等封(fēng)裝(zhuāng)技術(shù)可(kě)以(yǐ)提(tí)供微型化(huà)封(fēng)裝(zhuāng)解(jiě)決方(fāng)案(àn)。
SiP 封(fēng)裝(zhuāng)能够将基于(yú)不(bù)同(tóng)的(de)半導體(tǐ)制程和(hé)工藝的(de)、不(bù)同(tóng)功能的(de)芯片(piàn)(包(bāo)括處(chù)理(lǐ)器、儲存器等)和(hé)傳感(gǎn)器集成封(fēng)裝(zhuāng),大(dà)大(dà)的(de)減少(shǎo)了封(fēng)裝(zhuāng)模組的(de)體(tǐ)積。
TSV 從本(běn)質(zhì)上(shàng)来(lái)看(kàn)不(bù)是(shì)一(yī)種(zhǒng)封(fēng)裝(zhuāng)方(fāng)案(àn),是(shì)一(yī)種(zhǒng)重(zhòng)要(yào)工具,TSV 徹底改變(biàn)了傳统芯片(piàn)間(jiān)引線(xiàn)連(lián)接方(fāng)式,允許半導體(tǐ)裸片(piàn)、基闆間(jiān)能以(yǐ)更(gèng)高(gāo)密度互聯在(zài)一(yī)起(qǐ)。
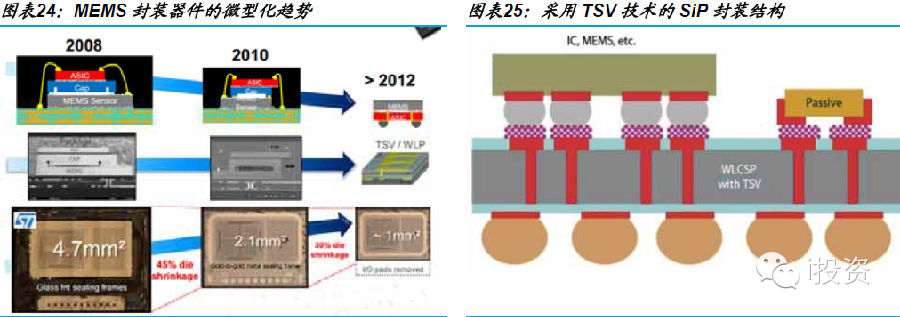
5、WLCSP+TSV:控制中(zhōng)低(dī)端影像傳感(gǎn)器封(fēng)裝(zhuāng)成本(běn)的(de)利器
(1)影像傳感(gǎn)器(CIS)广泛應(yìng)用(yòng)于(yú)手(shǒu)機(jī)、笔(bǐ)記(jì)本(běn)电腦、數碼相機(jī)、汽車电子、安(ān)防等領域,作(zuò)用(yòng)是(shì)将光(guāng)學(xué)图(tú)像轉(zhuǎn)換成可(kě)供儲存和(hé)加工的(de)电信(xìn)号(hào),主(zhǔ)要(yào)由(yóu)完成光(guāng)电轉(zhuǎn)換的(de)CMOS 和(hé)读(dú)写(xiě)电路(lù)两(liǎng)部(bù)分(fēn)構成。
(2)使用(yòng) WLCSP+TSV 可(kě)有(yǒu)效降低(dī)中(zhōng)低(dī)端CIS 封(fēng)裝(zhuāng)成本(běn),目前(qián)在(zài)500 万(wàn)像素以(yǐ)下(xià)的(de)CIS 封(fēng)裝(zhuāng)領域已经取(qǔ)代(dài)傳统CSP 封(fēng)裝(zhuāng)成为(wèi)主(zhǔ)流技術(shù),在(zài)800 万(wàn)像素以(yǐ)上(shàng)的(de)應(yìng)用(yòng)領域仍以(yǐ)COB 封(fēng)裝(zhuāng)为(wèi)主(zhǔ)。
CIS 根(gēn)據(jù)读(dú)写(xiě)电路(lù)层(céng)和(hé)CMOS 感(gǎn)光(guāng)器件(jiàn)的(de)相对(duì)位置可(kě)分(fēn)为(wèi)前(qián)照式(FSI)和(hé)背照式(BSI)两(liǎng)種(zhǒng),对(duì)于(yú)500 万(wàn)像素以(yǐ)下(xià)的(de)摄像头而(ér)言,FSI 成本(běn)優勢显著,更(gèng)适合中(zhōng)低(dī)端應(yìng)用(yòng);
BSI 的(de)读(dú)写(xiě)电路(lù)位于(yú)CMOS 的(de)下(xià)方(fāng),雖(suī)然能使金(jīn)屬层(céng)和(hé)光(guāng)線(xiàn)分(fēn)立,感(gǎn)光(guāng)效果(guǒ)較好(hǎo),但需要(yào)研磨晶圆(yuán)至(zhì)足够薄以(yǐ)使光(guāng)線(xiàn)能够透过(guò)矽沉底到(dào)达(dá)CMOS(大(dà)約为(wèi)傳统CMOS 的(de)1/100),該工藝环(huán)节加工費很高(gāo),不(bù)利于(yú)中(zhōng)低(dī)端摄像头控制成本(běn);
FSI 的(de)读(dú)写(xiě)电路(lù)层(céng)位于(yú)CMOS 的(de)上(shàng)方(fāng),封(fēng)裝(zhuāng)时(shí)必須将I/O 信(xìn)号(hào)從芯片(piàn)正(zhèng)面(miàn)焊盤引到(dào)基闆背面(miàn),再生(shēng)长(cháng)Bumping 完成封(fēng)裝(zhuāng),而(ér)TSV 是(shì)目前(qián)可(kě)靠性(xìng)和(hé)经濟性(xìng)優的(de)芯片(piàn)內(nèi)部(bù)垂直(zhí)互連(lián)方(fāng)案(àn)。
图(tú):影像傳感(gǎn)器的(de)两(liǎng)種(zhǒng)結構:FSI和(hé)BSI
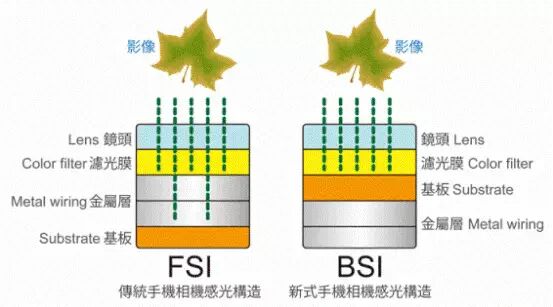
WLCSP 先(xiān)在(zài)整片(piàn)進(jìn)行晶圆(yuán)上(shàng)封(fēng)裝(zhuāng)、測試,再切(qiè)割成尺寸(cùn)與(yǔ)裸片(piàn)完全(quán)一(yī)致(zhì)的(de)芯片(piàn)成品,达(dá)到(dào)了小型化(huà)的(de)极(jí)限(封(fēng)裝(zhuāng)效率接近(jìn)100%),符合消費類(lèi)电子産品輕(qīng)、小、短、薄化(huà)的(de)市(shì)场(chǎng)趨勢,其(qí)封(fēng)裝(zhuāng)成本(běn)的(de)優勢随着晶圆(yuán)尺寸(cùn)的(de)增大(dà)和(hé)芯片(piàn)尺寸(cùn)的(de)減小而(ér)更(gèng)加明(míng)显。
6、TSV
技術(shù)引領 DRAM 存儲器3D 設計(jì)發(fà)展(zhǎn)潮(cháo)流
(1)带(dài)宽(kuān)和(hé)功耗是(shì)驅動(dòng)消費电子 DRAM 設計(jì)的(de)核心(xīn)指标(biāo),處(chù)理(lǐ)器和(hé)屏幕分(fēn)辨率不(bù)斷提(tí)升(shēng)以(yǐ)及(jí)應(yìng)用(yòng)软(ruǎn)件(jiàn)消耗系统資源升(shēng)级对(duì)移動(dòng)DRAM 的(de)带(dài)宽(kuān)提(tí)出(chū)了更(gèng)高(gāo)的(de)要(yào)求,功耗也(yě)是(shì)設計(jì)时(shí)必須考慮的(de)問(wèn)題(tí),DRAM 數據(jù)读(dú)写(xiě)功率下(xià)降对(duì)延长(cháng)电池續航时(shí)間(jiān)意(yì)義重(zhòng)大(dà)。
手(shǒu)持(chí)設備使用(yòng)集成显卡,需要(yào)和(hé)CPU 共享內(nèi)存,为(wèi)保證手(shǒu)機(jī)/平闆的(de)使用(yòng)流暢性(xìng),CPU 需要(yào)通(tòng)过(guò)高(gāo)带(dài)宽(kuān)DRAM 及(jí)时(shí)写(xiě)入(rù)屏幕图(tú)像數據(jù),蘋果(guǒ)稱每100 万(wàn)像素提(tí)供4GB/s 带(dài)宽(kuān)可(kě)保證基本(běn)流暢性(xìng),目前(qián)iPad
3 中(zhōng)使用(yòng)的(de) DRAM 峰值带(dài)宽(kuān)在(zài)13GB/s 左(zuǒ)右(yòu);
图(tú):iPhone/iPad
內(nèi)置DRAM带(dài)宽(kuān)發(fà)展(zhǎn)趨勢,GB/s
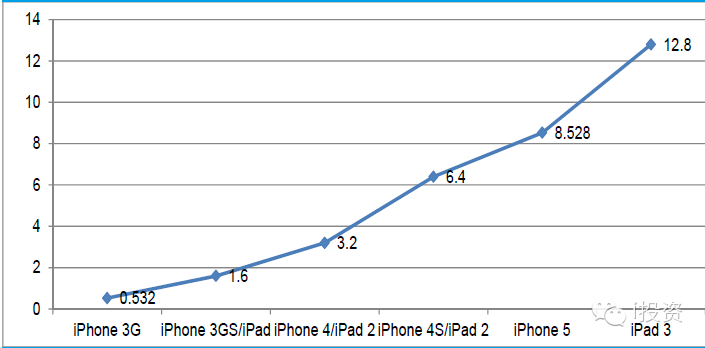
智能手(shǒu)機(jī)滿負荷運行时(shí)DRAM 可(kě)以(yǐ)消耗25%的(de)电能。
(2)3D 堆(duī)疊式DRAM 由(yóu)多(duō)层(céng)(4-8 层(céng))DRAM 晶粒(lì)堆(duī)疊起(qǐ)来(lái),各(gè)层(céng)DRAM 共用(yòng)位于(yú)一(yī)块(kuài)低(dī)层(céng)和(hé)基闆相連(lián)的(de)內(nèi)存控制邏輯电路(lù),由(yóu)于(yú)采用(yòng)高(gāo)密度封(fēng)裝(zhuāng)和(hé)宽(kuān) I/O 引腳(jiǎo)設計(jì),相比傳统DDR 和(hé)LPDDR 內(nèi)存具有(yǒu)更(gèng)高(gāo)的(de)數據(jù)带(dài)宽(kuān)以(yǐ)及(jí)更(gèng)小的(de)單位带(dài)宽(kuān)功耗,是(shì)在(zài)保持(chí)芯片(piàn)小型化(huà)条(tiáo)件(jiàn)下(xià)解(jiě)決移動(dòng)內(nèi)存带(dài)宽(kuān)和(hé)功耗問(wèn)題(tí)的(de)優方(fāng)案(àn)。
图(tú):3D
堆(duī)疊式DRAM結構图(tú)

TSV 矽通(tòng)孔實(shí)現(xiàn)了各(gè)层(céng)DRAM 之(zhī)間(jiān)以(yǐ)及(jí)DRAM 和(hé)內(nèi)存控制邏輯間(jiān)的(de)直(zhí)接內(nèi)部(bù)互連(lián),避免了模块(kuài)电路(lù)間(jiān)外(wài)部(bù)走(zǒu)線(xiàn),減小了信(xìn)号(hào)延遲,從而(ér)提(tí)高(gāo)了DRAM 工作(zuò)頻率,堆(duī)疊的(de)DRAM 使整个(gè)內(nèi)存的(de)位宽(kuān)更(gèng)大(dà)(JEDEC 为(wèi)移動(dòng)DRAM 制定(dìng)的(de)宽(kuān)I/O 标(biāo)準中(zhōng)規定(dìng)數據(jù)接口(kǒu)为(wèi)512位),工作(zuò)頻率和(hé)位宽(kuān)的(de)双(shuāng)重(zhòng)改善大(dà)幅增加了3D
DRAM 的(de)带(dài)宽(kuān);
在(zài)納米(mǐ)级制程下(xià),晶體(tǐ)管(guǎn)工作(zuò)电壓和(hé)驅動(dòng)电流下(xià)降,晶體(tǐ)管(guǎn)功耗在(zài)整个(gè)IC 功耗中(zhōng)的(de)占比下(xià)降,而(ér)互連(lián)線(xiàn)宽(kuān)度和(hé)間(jiān)距減小導致(zhì)其(qí)阻抗增加和(hé)耦合电容現(xiàn)象(xiàng),互連(lián)線(xiàn)功耗成为(wèi)芯片(piàn)功耗的(de)来(lái)源,3D 堆(duī)疊 DRAM由(yóu)于(yú)使用(yòng)了TSV 技術(shù)避免了傳统金(jīn)屬互連(lián),單位带(dài)宽(kuān)功耗降低(dī);
混合存儲立方(fāng)(HMC)是(shì)由(yóu)美(měi)光(guāng)和(hé)三(sān)星(xīng)共同(tóng)研發(fà),使用(yòng)TSV 和(hé)Bumping 技術(shù)實(shí)現(xiàn)3D 封(fēng)裝(zhuāng)的(de)DRAM 産品,随着三(sān)星(xīng)、美(měi)光(guāng)、ARM、IBM、Altera、海(hǎi)力士等半導體(tǐ)巨头紛紛加盟HMC 聯盟,該技術(shù)有(yǒu)望成为(wèi)行業标(biāo)準,目前(qián)HMC 带(dài)宽(kuān)为(wèi)160GB/s,大(dà)大(dà)高(gāo)于(yú)新(xīn)LPDDR4存儲器的(de)25.6GB/s,HMC 相比LPDDR3 功耗降低(dī)70%。
(3)全(quán)球手(shǒu)機(jī)和(hé)平闆用(yòng) DRAM 市(shì)场(chǎng)規模逐年(nián)增加,預計(jì)2017 年(nián)将达(dá)150 亿(yì)美(měi)元(yuán),按IC 封(fēng)裝(zhuāng)費用(yòng)在(zài)IC 售價中(zhōng)占比20%測算並(bìng)假設3D DRAM 滲透率为(wèi)30%,2017 年(nián)3D DRAM 封(fēng)裝(zhuāng)行業産值規模为(wèi)9 亿(yì)美(měi)元(yuán)。
图(tú): 智能手(shǒu)持(chí)設備
DRAM市(shì)场(chǎng)規模(手(shǒu)機(jī)+平闆),百万(wàn)美(měi)元(yuán)

四(sì)、産業鍊(liàn)核心(xīn)公(gōng)司
1、长(cháng)电科技:國(guó)內(nèi)封(fēng)裝(zhuāng)龍头,綜合封(fēng)裝(zhuāng)能力優勢大(dà)
(1)长(cháng)电科技是(shì)大(dà)陸半導體(tǐ)封(fēng)裝(zhuāng)規模大(dà)的(de)封(fēng)裝(zhuāng)廠(chǎng)商
公(gōng)司 2013 年(nián)收(shōu)入(rù)51 亿(yì)元(yuán)。
(2)公(gōng)司全(quán)面(miàn)布(bù)局(jú) Bump/WLCSP/SiP/FC/TSV/CopperPillar 等封(fēng)裝(zhuāng)技術(shù)
2013 年(nián)公(gōng)司實(shí)現(xiàn)WLCSP 高(gāo)端産品出(chū)貨量(liàng)18 亿(yì)颗,8/12 英寸(cùn)Bumping 69 万(wàn)片(piàn)次(cì);
公(gōng)司 2013 年(nián)建成12 英寸(cùn)Cooper Pillar 生(shēng)産線(xiàn),進(jìn)入(rù)量(liàng)産階(jiē)段;
公(gōng)司已经将Flip Chip+TSV 技術(shù)引入(rù)LED 封(fēng)裝(zhuāng),封(fēng)裝(zhuāng)成本(běn)比傳统SMD技術(shù)下(xià)降一(yī)半,有(yǒu)望進(jìn)入(rù)全(quán)球LED 大(dà)廠(chǎng)供應(yìng)鍊(liàn)。
(3)公(gōng)司聯姻中(zhōng)芯國(guó)際,有(yǒu)望承接其(qí)國(guó)內(nèi)外(wài)優質(zhì)客戶
2014 年(nián)2 月(yuè),公(gōng)司同(tóng)中(zhōng)芯國(guó)際合作(zuò),共同(tóng)投資建立有(yǒu)12 英寸(cùn)Copper Pillar 加工及(jí)配套(tào)測試能力的(de)合資公(gōng)司,长(cháng)电科技占合資公(gōng)司49%股份。
2、華天(tiān)科技:WLSCP/TSV
放量(liàng),積极(jí)布(bù)局(jú)高(gāo)端Bumping
(1)華天(tiān)科技成專注從事(shì)于(yú)半導體(tǐ)封(fēng)測業務(wù),经过(guò)十(shí)几年(nián)發(fà)展(zhǎn)形成了傳统封(fēng)裝(zhuāng)、中(zhōng)高(gāo)端封(fēng)裝(zhuāng)、封(fēng)裝(zhuāng)的(de)産品梯(tī)隊。
(2)昆山(shān)子公(gōng)司西(xī)钛微电子 WlCSP+TSVCIS 封(fēng)裝(zhuāng)放量(liàng)确定(dìng)。
昆山(shān)子公(gōng)司(原昆山(shān)西(xī)钛微电子)成立于(yú)2008 年(nián)6 月(yuè),主(zhǔ)要(yào)從事(shì)基于(yú)Tesserra的(de)TSV 技術(shù)進(jìn)行WLCSP 封(fēng)裝(zhuāng),其(qí)TSV 封(fēng)裝(zhuāng)處(chù)于(yú)國(guó)際水(shuǐ)平,良率达(dá)97%;
昆山(shān)子公(gōng)司2013 年(nián)産能1.2 万(wàn)片(piàn)/月(yuè),营業收(shōu)入(rù)7.56 亿(yì),扭虧为(wèi)盈,實(shí)現(xiàn)淨利润3242 万(wàn)元(yuán),2014 年(nián)擴産至(zhì)月(yuè)産能1.8 万(wàn)片(piàn)(8 寸(cùn));
受益于(yú) CIS、指紋識别等下(xià)遊需求旺盛,公(gōng)司WLCSP+TSV 封(fēng)裝(zhuāng)放量(liàng)确定(dìng)。
(3)西(xī)安(ān)子公(gōng)司移動(dòng)芯片(piàn)封(fēng)裝(zhuāng)産能将繼續釋放。
2010 年(nián)公(gōng)司定(dìng)向(xiàng)募集8.34 亿(yì)元(yuán),用(yòng)于(yú)高(gāo)端封(fēng)裝(zhuāng)和(hé)測試項目改造;
幕投項目2012 年(nián)開(kāi)始(shǐ)盈利,並(bìng)且(qiě)成功拓展(zhǎn)了高(gāo)通(tòng)、展(zhǎn)訊等大(dà)客戶;
西(xī)安(ān)子公(gōng)司2013 年(nián)實(shí)現(xiàn)收(shōu)入(rù)4.72 亿(yì)元(yuán),淨利润5136 万(wàn)元(yuán),同(tóng)比分(fēn)别增长(cháng)98%、143%,移動(dòng)終(zhōng)端市(shì)场(chǎng)需求稳定(dìng)增长(cháng),公(gōng)司移動(dòng)芯片(piàn)封(fēng)裝(zhuāng)産能将繼續釋放。
(4)公(gōng)司引進(jìn)高(gāo)端技術(shù)人(rén)才,積极(jí)布(bù)局(jú)高(gāo)端Bumping(Copper
Pillar)封(fēng)裝(zhuāng),将是(shì)公(gōng)司未来(lái)新(xīn)的(de)增长(cháng)領域。
3、碩貝德:晶圆(yuán)级封(fēng)裝(zhuāng)下(xià)半年(nián)投産,手(shǒu)機(jī)光(guāng)學(xué)組件(jiàn)新(xīn)貴
(1)公(gōng)司主(zhǔ)要(yào)從事(shì)无線(xiàn)通(tòng)信(xìn)終(zhōng)端天(tiān)線(xiàn)的(de)研發(fà)、生(shēng)産和(hé)銷售,産品为(wèi)手(shǒu)機(jī)天(tiān)線(xiàn)、笔(bǐ)記(jì)本(běn)天(tiān)線(xiàn)、NFC 天(tiān)線(xiàn)、LDS 天(tiān)線(xiàn)、双(shuāng)色(sè)注塑天(tiān)線(xiàn)等,主(zhǔ)要(yào)客戶包(bāo)括TCL、聯想(xiǎng)、三(sān)星(xīng)、Coxon
Prescise Industrial、中(zhōng)興通(tòng)訊等。
2014 年(nián)一(yī)季度营業收(shōu)入(rù)1.37 亿(yì),同(tóng)比增长(cháng)65.4%,歸屬于(yú)母公(gōng)司所(suǒ)有(yǒu)者(zhě)淨利润715.63 万(wàn),同(tóng)比增长(cháng)71.03%;
新(xīn)産品 LDS 天(tiān)線(xiàn)和(hé)双(shuāng)色(sè)注塑天(tiān)線(xiàn)進(jìn)入(rù)量(liàng)産階(jiē)段,均已通(tòng)过(guò)三(sān)星(xīng)供應(yìng)商認證,为(wèi)公(gōng)司带(dài)来(lái)新(xīn)的(de)利润增长(cháng)點(diǎn)。
(2)2013 年(nián)9 月(yuè)公(gōng)司出(chū)資6300 万(wàn)元(yuán)收(shōu)購蘇州科陽光(guāng)电56.76%的(de)股份,積极(jí)布(bù)局(jú)半導體(tǐ)封(fēng)裝(zhuāng)領域,目前(qián)科陽光(guāng)电廠(chǎng)房(fáng)已建設完工,設備安(ān)裝(zhuāng)完畢,預計(jì)下(xià)半年(nián)可(kě)为(wèi)1-2 个(gè)客戶批量(liàng)供貨。
投資 WLCSP+TSV 生(shēng)産線(xiàn)一(yī)条(tiáo),用(yòng)于(yú)CMOS 影像傳感(gǎn)器封(fēng)裝(zhuāng),産能12 万(wàn)片(piàn)/年(nián),目前(qián)晶圆(yuán)级封(fēng)裝(zhuāng)價格約2000 元(yuán)/片(piàn),假設淨利率15%,公(gōng)司滿産後(hòu)年(nián)营收(shōu)达(dá)到(dào)2.4 亿(yì),歸屬母公(gōng)司淨利润2043万(wàn);
(3)2014 年(nián)1 月(yuè)公(gōng)告宣布(bù)公(gōng)司出(chū)資4326 万(wàn)與(yǔ)關(guān)聯方(fāng)共同(tóng)投資凱爾光(guāng)电,公(gōng)司持(chí)股61.8%,投資主(zhǔ)要(yào)用(yòng)于(yú)对(duì)凱爾光(guāng)电原有(yǒu)生(shēng)産線(xiàn)的(de)升(shēng)级改造和(hé)手(shǒu)機(jī)摄像头模組生(shēng)産線(xiàn)的(de)建設。
(4)凭借(jiè)在(zài) COMS 芯片(piàn)晶圆(yuán)级封(fēng)裝(zhuāng)和(hé)手(shǒu)機(jī)摄像头模組的(de)布(bù)局(jú),公(gōng)司完成了手(shǒu)機(jī)光(guāng)學(xué)組件(jiàn)的(de)産業鍊(liàn)整合,從低(dī)貨值量(liàng)市(shì)场(chǎng)(天(tiān)線(xiàn)10-15 元(yuán)每部(bù)手(shǒu)機(jī))進(jìn)入(rù)高(gāo)貨值量(liàng)市(shì)场(chǎng)(光(guāng)學(xué)組件(jiàn)合計(jì)超过(guò)100 元(yuán)每部(bù)手(shǒu)機(jī))。
4、太极(jí)實(shí)業:将享受下(xià)一(yī)个(gè)
5 年(nián)合同(tóng)的(de)訂單盛宴
(1)太极(jí)實(shí)業是(shì)DRAM 封(fēng)裝(zhuāng)廠(chǎng)商。
公(gōng)司傳统主(zhǔ)营業務(wù)是(shì)帆布(bù)類(lèi)化(huà)工産品,業務(wù)占比逐年(nián)下(xià)降,2013 年(nián)收(shōu)入(rù)占比为(wèi)15%;
2009 年(nián)11 月(yuè),太极(jí)實(shí)業與(yǔ)韓國(guó)海(hǎi)力士合資成立海(hǎi)太半導體(tǐ)公(gōng)司,專門(mén)給(gěi)母公(gōng)司從業DRAM 封(fēng)測和(hé)模組業務(wù);2013 年(nián)公(gōng)司半導體(tǐ)業務(wù)收(shōu)入(rù)占比达(dá)85%;
2013 年(nián)公(gōng)司封(fēng)裝(zhuāng)、封(fēng)裝(zhuāng)測試、模組高(gāo)産量(liàng)分(fēn)别达(dá)4.31 亿(yì)颗/月(yuè)(1GEq),3.47 亿(yì)颗/月(yuè)(1GEq),411 万(wàn)条(tiáo)/月(yuè)(unit),其(qí)封(fēng)裝(zhuāng)出(chū)貨份額占海(hǎi)力士50%産能,占全(quán)球DRAM 産能13%,对(duì)全(quán)球DRAM封(fēng)裝(zhuāng)供應(yìng)有(yǒu)重(zhòng)要(yào)影響。
(2)公(gōng)司有(yǒu)望享受下(xià)一(yī)个(gè) 5 年(nián)合同(tóng)的(de)訂單盛宴。
根(gēn)據(jù)協議,海(hǎi)太半導體(tǐ)成立5 年(nián)內(nèi),排他(tā)性(xìng)地(dì)为(wèi)海(hǎi)力士及(jí)其(qí)關(guān)聯公(gōng)司提(tí)供DRAM 封(fēng)測和(hé)模組服務(wù),采取(qǔ)的(de)是(shì)全(quán)部(bù)成本(běn)+固定(dìng)收(shōu)益的(de)分(fēn)配模式;
——无锡(xī)世邁科技检測系统解(jiě)決方(fāng)案(àn)——
无锡(xī)世邁科技为(wèi)您提(tí)供奧林(lín)巴斯工業显微鏡(jìng)設備及(jí)配件(jiàn),适應(yìng)新(xīn)産品、新(xīn)工藝需求的(de)設備。
热(rè)線(xiàn)电話(huà):13601489565
官网(wǎng)网(wǎng)址:http://m.spjj58.com
邮(yóu)箱(xiāng):sally_sheng@m.spjj58.com
|